≤Ο¥ «Ψß‘≤ΦΕΖβΉΑΘΩΨß‘≤ΦΕΖβΉΑ÷°Έε¥σΦΦ θ“ΣΥΊ
ΉΖΥί–ΨΤ§ΖβΉΑάζ ΖΘ§ΫΪΒΞΗωΒΞ‘Σ¥”’ϊΗωΨß‘≤÷–«–Ηνœ¬ά¥‘ΌΫχ––Κσ–χΖβΉΑ≤β ‘ΒΡΖΫ Ϋ“Μ÷±“‘ά¥ΕΦ «ΑκΒΦΧε–ΨΤ§÷Τ‘λΒΡΓΑΙφΕ®ΡΘ ΫΓ±ΓΘ»ΜΕχΘ§ΥφΉ≈–ΨΤ§÷Τ‘λ≥…±ΨΒΡΖ…ΥΌΧα…ΐ“‘ΦΑœϊΖ― –≥ΓΕ‘”Ύ–ΨΤ§–‘ΡήΒΡ≤ΜΕœΉΖ«σΘ§»ΥΟ«ΩΣ Φ“β ΕΒΫΗο–¬œ»ΫχΖβΉΑΦΦ θΒΡ±Ί“Σ–‘Θ§“ρ¥ΥΘ§ Ψß‘≤ΦΕΖβΉΑΒ°…ζΝΥΓΘ
Ψß‘≤ΦΕΖβΉΑ(Wafer Level PackagingΘ§Υθ–¥WLP) «“Μ÷÷œ»ΫχΒΡΖβΉΑΦΦ θΘ§“ρΤδΨΏ”–≥Ώ¥γ–ΓΓΔΒγ–‘Ρή”≈ΝΦΓΔ…Δ»»ΚΟΓΔ≥…±ΨΒΆΒ»”≈ ΤΘ§ΫϋΡξά¥ΖΔ’Ι―ΗΥΌΓΘΗυΨίVerified Market Research ―–ΨΩ ΐΨίΘ§Ψß‘≤ΦΕΖβΉΑ –≥Γ 2020 ΡξΈΣ 48.4 “ΎΟά‘ΣΘ§‘ΛΦΤΒΫ 2028 ΡξΫΪ¥οΒΫ 228.3 “ΎΟά‘ΣΘ§¥” 2021 ΡξΒΫ2028 ΡξΒΡΗ¥ΚœΡξ‘ω≥Λ¬ ΈΣ 21.4%ΓΘ
≤ΜΆ§”Ύ¥ΪΆ≥ΖβΉΑΙΛ“’Θ§Ψß‘≤ΦΕΖβΉΑ «‘Ύ–ΨΤ§ΜΙ‘ΎΨß‘≤…œΒΡ ±ΚρΨΆΕ‘–ΨΤ§Ϋχ––ΖβΉΑΘ§±ΘΜΛ≤ψΩ…“‘πΛΫ”‘ΎΨß‘≤ΒΡΕΞ≤ΩΜρΒΉ≤ΩΘ§»ΜΚσΝ§Ϋ”Βγ¬ΖΘ§‘ΌΫΪΨß‘≤«–≥…ΒΞΗω–ΨΤ§ΓΘ
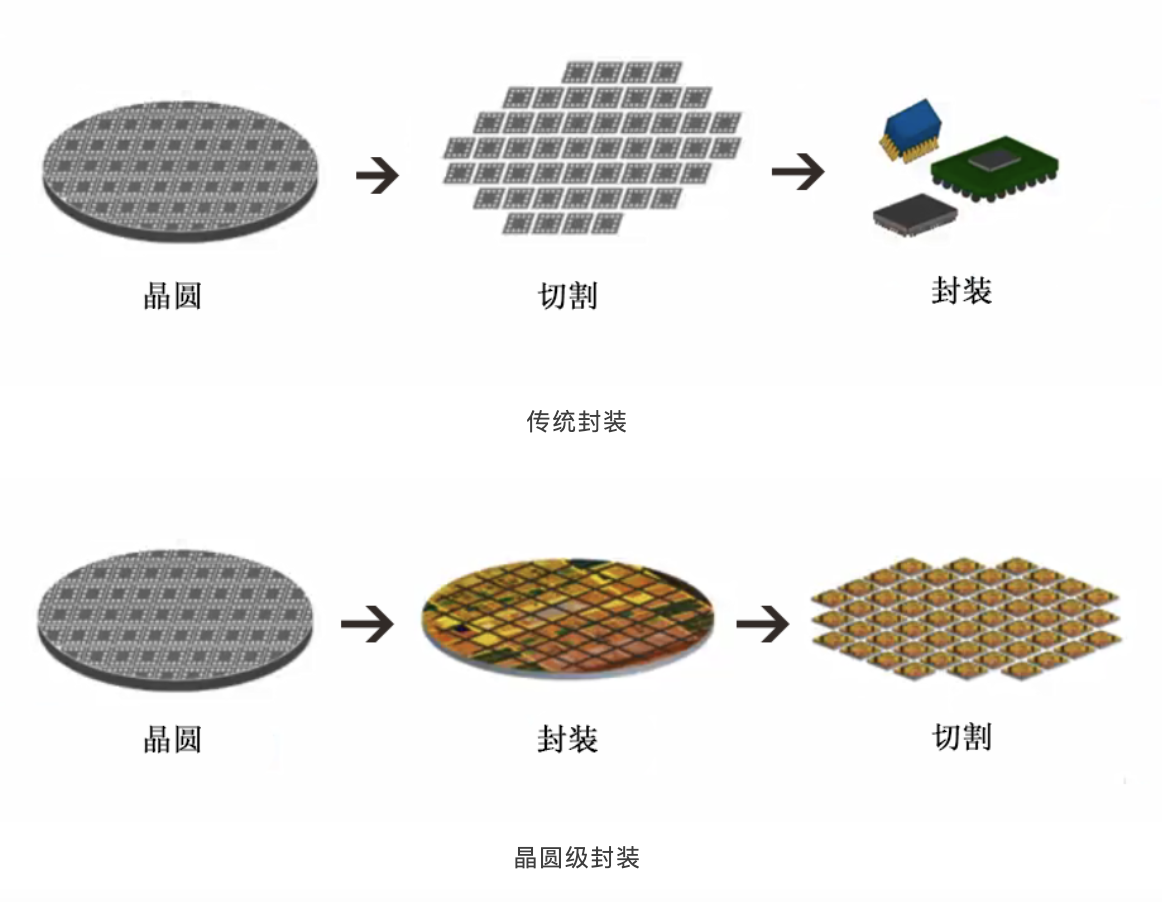
Ψß‘≤ΦΕΖβΉΑΦΦ θ”κ¥ρœΏ–ΆΘ®Wire-BondΘ©ΚΆΒΙΉΑ–ΆΘ®Flip-ChipΘ©ΖβΉΑΦΦ θœύ±» Θ§Ρή Γ»Ξ¥ρΫπ τœΏΓΔΆβ―”“ΐΫ≈Θ®»γQFPΘ©ΓΔΜυΑεΜρ“ΐœΏΩρΒ»ΙΛ–ρΘ§Υυ“‘ΨΏ±ΗΖβΉΑ≥Ώ¥γ–ΓΓΔΒγΤχ–‘ΡήΚΟΒΡ”≈ ΤΓΘΖβΉΑ––“ΒΒΡΝλ≈ή’ΏΟ«¥σΕύΜυ”ΎΨß‘≤ΡΘ Ϋά¥≈ζΝΩ…ζ≤ζœ»ΫχΨß‘≤ΦΕΖβΉΑ≤ζΤΖΘ§≤ΜΒΪΩ…άϊ”Οœ÷”–ΒΡΨß‘≤ΦΕ÷Τ‘λ…η±Ηά¥Άξ≥…÷ςΧεΖβΉΑ÷Τ≥ΧΒΡ≤ΌΉςΘ§Εχ«“»ΟΖβΉΑΫαΙΙΓΔ–ΨΤ§≤ΦΨ÷ΒΡ…ηΦΤ≤Δ––≥…ΈΣœ÷ ΒΘ§ΫχΕχœ‘÷χΥθΕΧΝΥ…ηΦΤΚΆ…ζ≤ζ÷ήΤΎΘ§ΫΒΒΆΝΥ’ϊΧεœνΡΩ≥…±ΨΓΘ
œύ±»”Ύ¥ΪΆ≥ΖβΉΑΘ§Ψß‘≤ΦΕΖβΉΑΨΏ”–“‘œ¬”≈ΒψΘΚ
1ΓΔΖβΉΑ≥Ώ¥γ–Γ
”…”ΎΟΜ”–“ΐœΏΓΔΦϋΚœΚΆΥήΫΚΙΛ“’Θ§ΖβΉΑΈό–ηœρ–ΨΤ§Άβά©’ΙΘ§ ΙΒΟWLPΒΡΖβΉΑ≥Ώ¥γΦΗΚθΒ»”Ύ–ΨΤ§≥Ώ¥γΓΘ
2ΓΔΗΏ¥Ϊ δΥΌΕ»
”κ¥ΪΆ≥Ϋπ τ“ΐœΏ≤ζΤΖœύ±»Θ§WLP“ΜΑψ”–ΫœΕΧΒΡΝ§Ϋ”œΏ¬ΖΘ§‘ΎΗΏ–ßΡή“Σ«σ»γΗΏΤΒœ¬Θ§Μα”–ΫœΚΟΒΡ±μœ÷ΓΘ
3ΓΔΗΏΟήΕ»Ν§Ϋ”
WLPΩ…‘Υ”Ο ΐΉι ΫΝ§Ϋ”Θ§–ΨΤ§ΚΆΒγ¬ΖΑε÷°ΦδΝ§Ϋ”≤Μœό÷Τ”Ύ–ΨΤ§ΥΡ÷ήΘ§ΧαΗΏΒΞΈΜΟφΜΐΒΡΝ§Ϋ”ΟήΕ»ΓΘ
4ΓΔ…ζ≤ζ÷ήΤΎΕΧ
WLP¥”–ΨΤ§÷Τ‘λΒΫΓΔΖβΉΑΒΫ≥…ΤΖΒΡ’ϊΗωΙΐ≥Χ÷–Θ§÷–ΦδΜΖΫΎ¥σ¥σΦθ…ΌΘ§…ζ≤ζ–߬ ΗΏΘ§÷ήΤΎΥθΕΧΚήΕύΓΘ
5ΓΔΙΛ“’≥…±ΨΒΆ
WLP «‘ΎΙηΤ§≤ψΟφ…œΆξ≥…ΖβΉΑ≤β ‘ΒΡΘ§“‘≈ζΝΩΜ·ΒΡ…ζ≤ζΖΫ Ϋ¥οΒΫ≥…±ΨΉν–ΓΜ·ΒΡΡΩ±ξΓΘWLPΒΡ≥…±Ψ»ΓΨω”ΎΟΩΗωΙηΤ§…œΚœΗώ–ΨΤ§ΒΡ ΐΝΩΘ§–ΨΤ§…ηΦΤ≥Ώ¥γΦθ–ΓΚΆΙηΤ§≥Ώ¥γ‘ω¥σΒΡΖΔ’Ι«ς Τ ΙΒΟΒΞΗωΤςΦΰΖβΉΑΒΡ≥…±Ψœύ”ΠΒΊΦθ…ΌΓΘWLPΩ…≥δΖ÷άϊ”ΟΨß‘≤÷Τ‘λ…η±ΗΘ§…ζ≤ζ…η ©Ζ―”ΟΒΆΓΘ
–η“Σ«ΩΒςΒΡ“ΜΒψ «Θ§”κ¥ρœΏ–ΆΖβΉΑΦΦ θ≤ΜΆ§Θ§”ΟΨß‘≤ΦΕΖβΉΑ”ΟΨß‘≤ΦΕΖβΉΑΦΦ θά¥ Βœ÷«ΜΡΎ–≈Κ≈≤ΦœΏΘ®Internal Signal RoutingΘ©Θ§”–ΕύΗω―ΓœνΘΚΨß‘≤ΦΕΆΙΩιΘ®Wafer BumpingΘ©ΦΦ θΓΔ‘ΌΖ÷≤Φ≤ψΘ®Re-Distribution LayerΘ©ΦΦ θΓΔΙηΫι≤ψΘ®Silicon InterposerΘ©ΦΦ θΓΔΙ祩ٹȮThrough Silicon ViaΘ©ΦΦ θΒ»ΓΘ
œ»ΫχΨß‘≤ΦΕΖβΉΑΦΦ θΘ§÷ς“ΣΑϋά®ΝΥΈε¥σ“ΣΥΊΘΚ
ΔΌΨß‘≤ΦΕΆΙΩιΘ®Wafer BumpingΘ©ΦΦ θΘΜ
ΔΎ…»»κ–ΆΘ®Fan-InΘ©Ψß‘≤ΦΕΖβΉΑΦΦ θΘΜ
Δέ…»≥ω–ΆΘ®Fan-OutΘ©Ψß‘≤ΦΕΖβΉΑΦΦ θΘΜ
Δή2.5D Ψß‘≤ΦΕΖβΉΑΦΦ θΘ®ΑϋΚ§IPDΘ©ΘΜ
Δί3D Ψß‘≤ΦΕΖβΉΑΦΦ θΘ®ΑϋΚ§IPDΘ©ΓΘ
Ψß‘≤ΆΙΩιΘ®Wafer BumpingΘ©Θ§ΙΥΟϊΥΦ“εΘ§Φ¥ «‘Ύ«–ΗνΨß‘≤÷°«ΑΘ§”ΎΨß‘≤ΒΡ‘Λ…ηΈΜ÷Ο…œ–Έ≥…ΜρΑ≤ΉΑΚΗ«ρΘ®“ύ≥ΤΆΙΩιΘ©ΓΘΨß‘≤ΆΙΩι « Βœ÷–ΨΤ§”κ PCB ΜρΜυΑεΘ®SubstrateΘ©ΜΞΝ§ΒΡΙΊΦϋΦΦ θΓΘΆΙΩιΒΡ―Γ≤ΡΓΔΙΙ‘λΓΔ≥Ώ¥γ…ηΦΤΘ§ ήΕύ÷÷“ρΥΊ”ΑœλΘ§»γΖβΉΑ¥σ–ΓΓΔ≥…±ΨΦΑΒγΤχΓΔΜζ–ΒΓΔ…Δ»»Β»–‘Ρή“Σ«σΓΘ
”ΓΥΔ–ΆΆΙΒψΘ®Printed BumpΘ©ΦΦ θΓΔΙ≤ΨßΒγΕΤ–Ά¬δ«ρΘ®Ball Drop with Eutectic PlatingΘ©ΦΦ θΓΔΈό«ΠΚœΫπΘ®Lead-Free AlloyΘ©ΦΑΆ≠÷ß÷υΚœΫπΘ®Copper-Pillar AlloyΘ©ΆΙΒψΦΦ θΘ§…»»κ–ΆΨß‘≤ΦΕΖβΉΑΘ®Fan-In Wafer Level PackageΘ§FIWLPΘ©ΦΦ θΘ§“ΒΡΎ“ύ≥ΤΨß‘≤ΦΕ–ΨΤ§ΙφΡΘΖβΉΑΘ®Wafer Level Chip Scale PackageΘ§WLCSPΘ©ΦΦ θΘ§ «Β±ΫώΗςάύΨß‘≤ΦΕΖβΉΑΦΦ θ÷–ΒΡ÷ςΝΠΓΘΫϋΝΫΡξΘ§…»»κ–ΆΨß‘≤ΦΕΖβΉΑ≤ζΤΖΒΡ»Ϊ«ρ≥ωΜθΝΩΕΦ±Θ≥÷‘ΎΟΩΡξ»ΐΑΌ“ΎΩ≈“‘…œΘ§÷ς“ΣΙ©Ηχ ÷ΜζΓΔ÷«Ρή¥©¥ςΒ»±ψ–·–ΆΒγΉ”≤ζΤΖ –≥ΓΓΘ
ΥφΉ≈±ψ–·–ΆΒγΉ”≤ζΤΖΒΡΩ’Φδ≤ΜΕœΥθ–ΓΓΔΙΛΉςΤΒ¬ »’“φ…ΐΗΏΦΑΙΠΡή–η«σΒΡΕύ―υΜ·Θ§–ΨΤ§ δ»κ/ δ≥ωΘ®I/OΘ©–≈Κ≈Ϋ”ΩΎΒΡ ΐΡΩ¥σΖυ‘ωΦ”Θ§ΆΙΩιΦΑΚΗ«ρΦδΨύΘ®Bump Pitch & Ball PitchΘ©ΒΡΨΪΟή≥ΧΕ»“Σ«σΫΞ«ς―œΗώΘ§‘ΌΖ÷≤Φ≤ψΘ®RDLΘ©ΦΦ θΒΡΝΩ≤ζΝΦ¬ “≤“ρ¥Υ‘ΫΖΔ ή÷Ί ”ΓΘ‘Ύ’β÷÷±≥ΨΑœ¬Θ§…»≥ω–ΆΖβΉΑΘ®Fan-Out Wafer Level PackageΘ§FOWLPΘ© ΦΑ…»»κ…»≥ωΜλΚœ–ΆΘ®Hybrid Fan-In/Fan-OutΘ©Β»ΗΏΕΥΨß‘≤ΦΕΖβΉΑΦΦ θ”Π‘ΥΕχ…ζΓΘ
≤Μ¬έΉ≈―έœ÷‘ΎΘ§ΜΙ «Ζ≈―έΈ¥ά¥Θ§ΥφΉ≈ 5GΓΔ»ΥΙΛ÷«ΡήΓΔΈοΝΣΆχΒ»¥σΦΦ θ«ς Τ±Φ”ΩΕχ÷ΝΘ§‘ΎΗΏΟήΕ»“λΙΙΦ·≥…ΒΡΦΦ θΨΚ»ϋ÷–Θ§Ψß‘≤ΦΕΖβΉΑΦΦ θ±ΊΫΪ’Φ”–“Μœ·÷°ΒΊΓΘ
Γχ ΉΔΘΚΈΡ’¬’ϊάμΉΣ‘Ί”ΎΆχ¬γΘ§ΫωΙ©≤ΈΩΦ―ßœΑΘ§Αφ»®Ιι‘≠Ής’ΏΥυ”–Θ§»γ…φΦΑ«÷»®Θ§«κΝΣœΒ–Γ±ύ…Ψ≥ΐΓΘ
PreΘΚ«≥ΈωΘΚ ≤Ο¥ «Ψß‘≤Θ§Ψß‘≤”–ΡΡ–©”Π”ΟΘΩ 2026-05-10
NextΘΚ≥ΘΦϊΒΡΈοΝΣΆχ–ΨΤ§”–ΡΡ–©ΘΩ 2026-05-10

 Collect
Collect
 NavigateΘΚ
NavigateΘΚ






